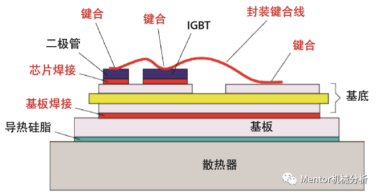
电子电力模块及其相关组件和系统的设计人员必须确保芯片和基板之间的热阻值尽可能保持较低水平,创造稳定可靠的键合并确保芯片粘接层在产品的使用寿命内能够承受极大的热载荷(图 1)。设计人员必须了解更大载荷循环数和器件温度/载荷条件之间的关系,才能较为准确地估算功率模块的使用寿命。
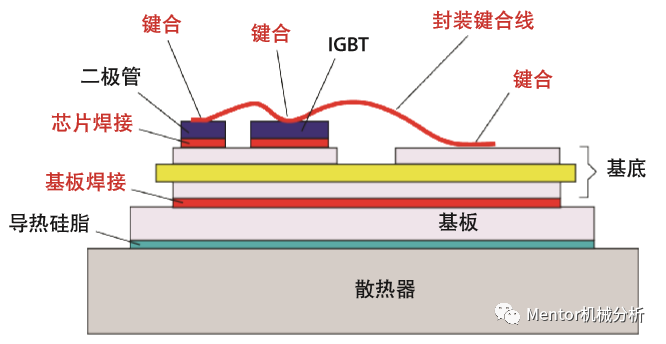
图 1:典型 IGBT 模块的横截面。
随着纯电动和混合动力车辆的问世,IGBT 器件在牵引和高压变流器应用领域已占据龙头地位,而各种结点中散发的热量对这些元器件的可靠性会有很大影响。器件工作过程中的高结温和高温度梯度会引起热-机械应力,在热膨胀系数不同的两种材料接触面上尤其明显,而这可能导致这些元器件降级甚至完全失效。
我们对四个包含两个半桥的中功率 IGBT 模块进行了两次测试,以验证可通过元器件自动功率循环获得的丰富数据。这些实验的详细信息先后在 2013 年 IEEE 电子封装技术大会和 2014 年半导体热计量与管理 (SEMI-THERM) 研讨会 [7, 8] 上介绍过。
这些模块被固定在 Power Tester 1500A 中集成的冷板上(采用液冷散热),用一块高热导率导热垫来尽量减小界面间的热阻。在整个实验过程中,我们通过 Power Tester 1500A 控制的液冷循环器将冷板温度始终保持在 25 °C。
我们将器件的栅极连接到了漏极(即所谓的“金属氧化物半导体”- MOS 二极管设置),同时对各个半桥使用单独的驱动电路供电,两个电流源分别连接到相应的半桥。使用一个可以快速切换开关状态的大电流电源对这些器件施加阶跃式功率变化。另外使用一个低电流电源为 IGBT 提供连续偏压,这样可在加热电流关闭时测量器件温度。
在第一组测试中,我们采用恒定的加热和冷却时间对四个样品分别进行了测试。选择的加热和冷却时间分别是加热 3 秒钟和冷却 10 秒钟,在 200 W 功率条件下将初始温度波动保持在 100 °C 左右。这样的测试设置可以最贴切地模拟实际应用环境,在此环境中,热结构的降级会导致结温升高,进而加速器件老化。
在这四个受测器件中,样品 3 在经过 10,000 次循环后不久便失效了,远远早于其他样品。样品 0、 1 和 2 持续 时间较长,分别在经过 40,660、41,476 和 43,489 次功率循环后失效。图 2 显示了样品 0 的瞬态热测试(每 5,000 次循环测量一次)生成的结构函数。位于 0.08 Ws/K 的平坦区域对应于芯片粘接层。该结构在 15,000 次循环之前是稳定的,但过了这个点之后,随着热阻持续增大,芯片粘接层出现明显降级,直至器件失效。虽然导致器件失效的直接原因仍然不明,但我们发现,栅极和射极之间形成了短路,而且在芯片表面可以看到一 些焦斑。
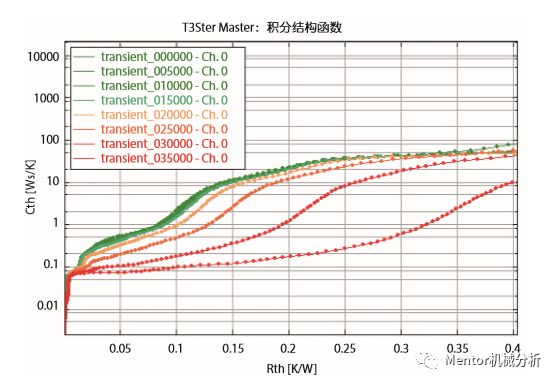
图 2:样品 0 在不同时间点的控制测量值对应的结构函数。
在第二组测试中,我们分别采用不同的供电策略(由 Power Tester 1500A 提供支持)对完全相同的样品进行了测试。模块中的两个半桥分别安装在同一块基板的不同基底上。三个器件均采用两种封装进行了测试,其中受测器件中的 IGBT1 和 IGBT3 属于同一模块,但位于不同的半桥。
我们对 IGBT1 保持恒定的电流,对 IGBT2 保持恒定的加热功率,对 IGBT3 则保持恒定的结温变化。选择的设 置能够为所有器件提供相同的初始结点温升,即对每个器件加热 3 秒钟和冷却 17 秒钟,初始加热功率约 240 W,确保对比结果公平公正。
对每个器件分别测量了所有循环中全部的加热和冷却瞬态变化,并由 Power Tester 1500A 对下列电学参数和 热学参数进行了持续监测:
1. 加热电流开启后的器件电压
2. 上一循环中施加的加热电流
3. 功率阶跃
4. 加热电流关闭后的器件电压
5. 加热电流开启前的器件电压
6. 上一功率循环期间的最高结温
7. 上一功率循环期间的最低结温
8. 上一循环中的温度波动
9. 使用加热功率进行标准化处理后的温度变化
在使用 10A 加热电流完成 250 次循环后,我们对器件从通电稳态到断电稳态之间的全程热瞬态变化进行了测量,用以创建可对热量累积中发生的降级进行研究的结构函数。同样,实验持续进行到所有 IGBT 全部失效为 止。不出所料,IGBT1 最先失效,因为在器件降级过程中我们没有对供电功率进行任何调节。但有趣的是,在该热结构中并没有显示任何降级迹象(图 3)。
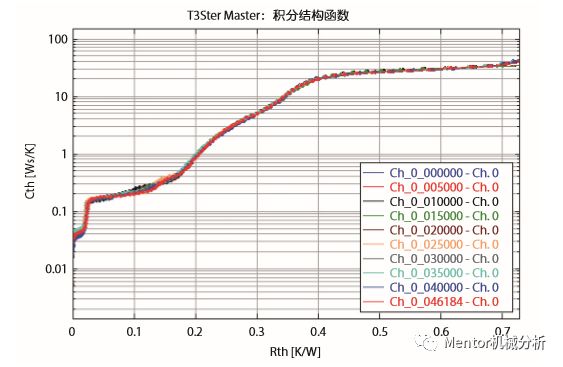
图 3:IGBT1 在功率循环期间的结构函数变化。
我们对实验过程中的器件电压变化进行了检查。图 4 显示了 IGBT1 在加热电流水平的正向电压变化与已完成的功率循环次数之间的关系。在前 3000 次循环中,可以观察到电压处于下降趋势。导致初期这一变化的原因主要是器件平均温度变化相对缓慢(只下降了 5 °C)。尽管器件电压的温度依赖性在电流低时呈现负特性,但在大电流水平下,正向电压的温度依赖性已变为正值。

图 4:IGBT1 在加热电流水平的正向电压与已应用的功率循环数之间的关系。
在经过约 35,000 次循环后,这一趋势发生了变化,电压开始缓慢升高。之后,器件电压出现阶跃式变化,同时,上升趋势持续加快,直至最终器件失效。电压的增大可归因于封装键合线的降级,因为结构函数并没有变化,这也解释了在封装键合线最终脱落时电压出现的阶跃式变化。电压阶跃高度的持续增加是因为随着封装键合线数量的减少,封装键合线热阻的并联电阻之和在不断增大。如果采用恒定电流的策略,封装键合线 的断裂会增加剩余键合线中的电流密度,并且加速老化。
图 5 显示了 IGBT3 对应的同类型曲线,其中,器件电压转为增长趋势的时间甚至更早,但由于通过调节加热电流保持了结温恒定,因此加热电流也按比例相应地减小了。电流的减小降低了键合线的负载,并延长了器件测试的寿命。

图 5:IGBT3 在加热电流水平的正向电压与已应用的功率循环数之间的关系。
上述两组实验展示了不同的失效模式,并说明了不同的功率策略以及电气设置对失效模式可能产生的影响。 第一组实验采用的是恒定循环时间,最贴切地反映了实际的应用情况,实验证明 Power Tester 1500A 能够快速检测出器件结构(包括芯片粘接层和其他受破坏层)内出现的降级现象。
第二组实验清楚地证明封装键合线出现了降级现象,因为我们观察到器件的正向电压出现了阶跃式升高,但对于不同的供电选项(恒定电流、恒定加热功率和恒定温升),所有测试样品的热结构函数都没有发生变化。 当然,由于样品数量较少,所以只能做出比较保守的结论。假以时日,如果增加样本数量,一定会提供更多的统计数据。但是,在 Power Tester 1500A 实验中也可以发现,测量结果可能因循环策略的不同而有所差异,基于某些策略而预测的功率器件使用寿命可能会高于其实际的使用寿命。
本文来源:Mentor机械分析。
产品分享:


贝思科尔(BasiCAE),专注为国内高科技电子及半导体等行业提供先进的电子/结构设计、散热仿真分析、半导体热可靠性测试及设计数据信息化管理的解决方案和咨询服务。









 苏公网安备 32059002002276号
苏公网安备 32059002002276号
